 |
 |
随着半导体产业向高集成度、小型化方向演进,先进封装工艺对设备的精度控制、系统稳定性、自动化协同及可扩展性提出了更高要求。传统封装设备方案在应对高精度贴装长期稳定性、多工艺兼容性以及检测微小缺陷方面存在明显局限,这些技术瓶颈直接影响产线整体效率与良率表现。如何在维持微米级精度的同时兼顾生产节拍,如何在多产品切换场景中降低停机损耗,成为封装设备供应商需要突破的关键命题。
苏州博众半导体有限公司成立于2022年,总部位于中国江苏苏州,专注于半导体贴装设备及芯片AOI检测设备的研发、制造与应用解决方案。依托集团工程经验,博众半导体围绕先进封装需求,提供稳定运行的贴装与检测单元,支持封装产线效率与可靠性的提升。
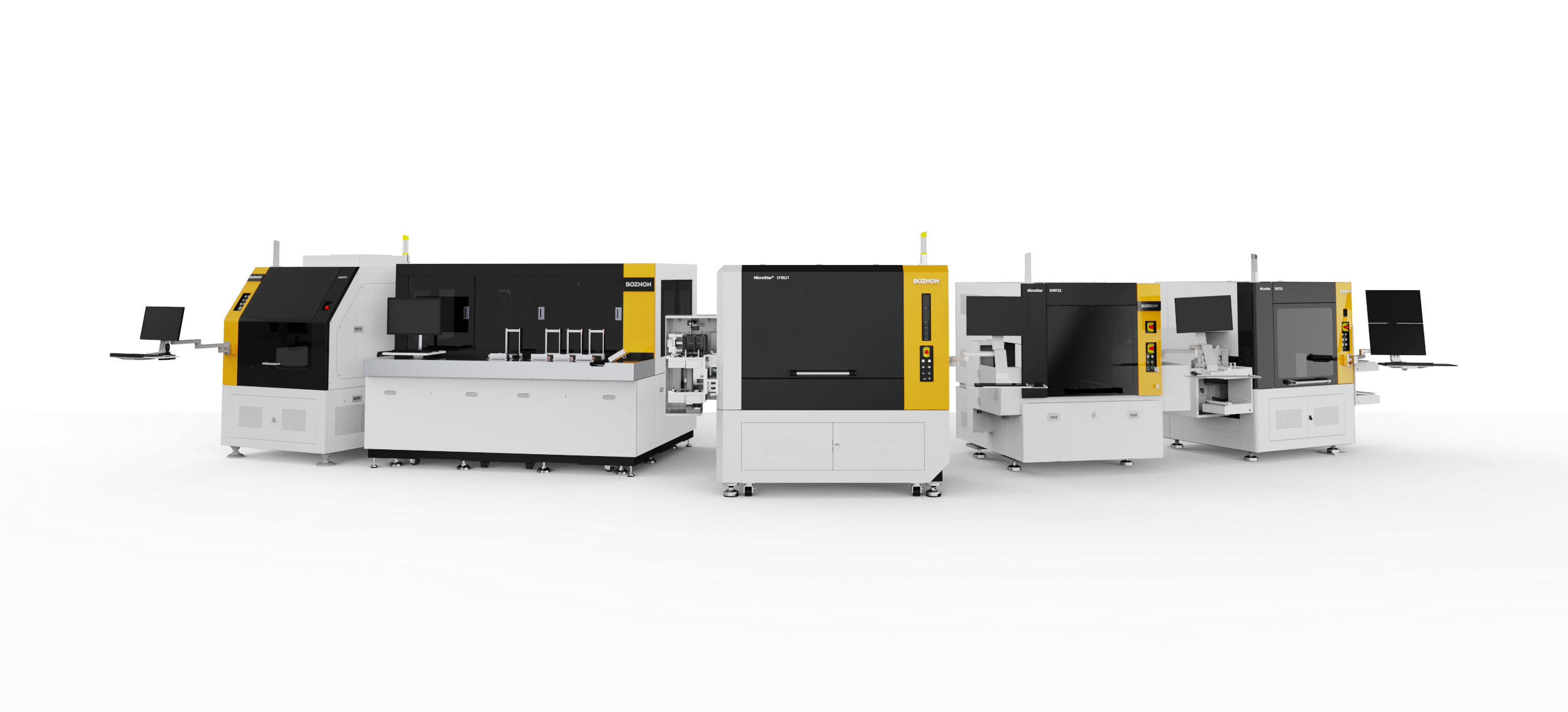
精度稳定性的实现路径

在共晶贴装场景中,贴装精度直接影响焊接质量与器件性能。博众半导体星威EH9722共晶机采用龙门双驱动结构与高精度视觉系统,贴片精度达±1.5um@3σ,有效降低焊接风险。龙门双驱动结构通过提升设备运行的机械稳定性,解决高精度贴装的长期稳定性问题;高精度视觉系统实现准确定位,解决贴装位置偏差影响性能的问题。这一技术组合适用于光模块、传感器、射频器件、功率器件、激光雷达及微波天线等对贴装精度敏感的应用领域。
多工艺兼容能力的构建
封装类型的多样化要求设备具备工艺切换能力。星威EH9722共晶机支持共晶、蘸胶、UV及FlipChip等多种贴片工艺,适配COC、COS、COB等多种封装方式,通过载具扫码绑定功能实现数据追踪与自动化对接,解决产线协同效率低的问题。设备支持弹匣上下料并可对接AGV,减少人工干预,提升自动化集成水平。
速度与精度的平衡实现
在固晶贴装场景中,高速运行往往带来精度损耗。星驰DU9721固晶机结合热漂补偿与闭环力控系统,贴装精度达±7um@3σ,效率高可达1500UPH。热漂补偿与闭环力控系统通过实时修正运动偏差与压力,解决高速运行下的精度损耗问题。
柔性生产的技术支撑
设备支持8–12英寸晶圆,兼容点胶、SIP、UV贴片等工艺,自动换吸嘴系统支持7个吸嘴切换,解决多芯片封装切换效率低的问题。这一柔性生产能力使设备适用于IC芯片、电子模组及功率器件封装场景。
微小缺陷识别的技术突破
封装产线中,微小缺陷的识别能力直接影响良率判断准确性。星准TV系列AOI检测机采用2D/3D光学检测技术,精度达5um@3σ,小缺陷识别能力达20um。2D/3D光学检测技术通过识别焊球、引脚、焊盘形貌,解决传统2D方案在高度判断上的局限。
检测效率与覆盖面的提升
4×4吸嘴配置结合高速分选设计,效率高可达60KUPH,通过提升取放与检测节拍,解决检测环节制约整线产能的问题。设备支持Top/Bottom/Side/IR及微裂纹检测,兼容从2×2mm至120×120mm的多种芯片尺寸,多模式检测(IR/微裂纹)覆盖多种缺陷类型,解决单一检测模式覆盖面不足的问题。这一检测能力适用于半导体封装产线中的在线或离线检测,涵盖QFP、SOP、LGA、FCBGA、CSP、WLP等封装类型。
博众半导体共享集团研发体系,集团研发人员规模达2147人,研发投入占比为11.57%,累计获得知识产权2919项。这一研发体系为公司在高精度贴装、多工艺兼容、精细检测等技术方向的持续迭代提供支撑。
博众半导体的贴装与检测设备在先进封装产线中承担着精度控制与质量保障的双重角色。通过高精度视觉系统与机械结构设计,设备在光模块、传感器、射频器件、功率器件等领域实现微米级贴装精度;通过多工艺兼容与自动化集成能力,设备支持COC、COS、COB等多种封装方式的快速切换;通过2D/3D光学检测技术,设备在QFP、SOP、LGA、FCBGA、CSP、WLP等封装类型中实现微小缺陷的有效识别。这些技术能力的组合,为封装产线效率与良率的提升提供了系统化解决方案。
在先进封装设备领域,精度、效率、柔性与检测能力的协同提升,正在重新定义产线价值创造的路径。博众半导体通过技术积累与工程经验的转化,为半导体封装产业的高质量发展提供设备层面的支撑。
(正文已结束)
免责声明及提醒:此文内容为本网所转载企业宣传资讯,该相关信息仅为宣传及传递更多信息之目的,不代表本网站观点,文章真实性请浏览者慎重核实!任何投资加盟均有风险,提醒广大民众投资需谨慎!